
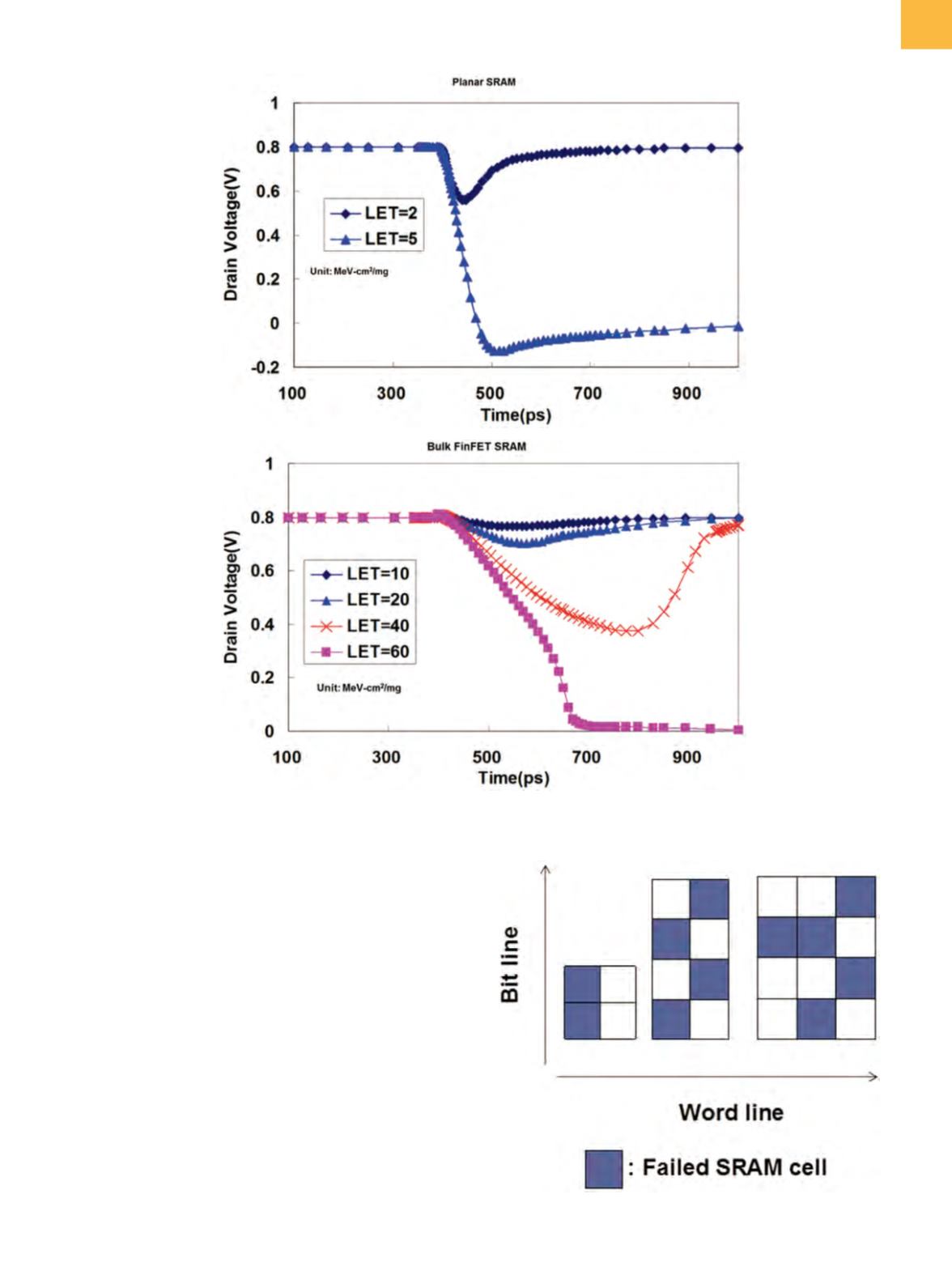 edfas.org
edfas.org
21
ELECTRONIC DEVICE FAILURE ANALYSIS | VOLUME 18 NO. 2
exhibit approximately an order of magnitude decrease
in soft errors compared to planar transistors at the same
technology node. This is consistent with the experimen-
tally observed decrease in soft error in Fig. 3.
MULTICELL ERRORS
Thus far, only single-bit errors have been considered
for all particle sources. In reality, for high-energy neutrons
in particular, the range of errors introduced is larger than
this, and it is common to observe multiple bits (multicell
upsets, or MCUs) being simultaneously upset by a fast
neutron strike. Figure 8 shows examples of the MCU bit
map in a SRAMarray. As Fig. 3(b) shows, themagnitude of
MCU events has decreased in tandemwith SBU events as
silicon technology has progressed, with FinFETs showing
a similarly large reduction compared to planar devices
Fig. 7
Drain voltage variation with different LETs for (a) planar and (b) bulk FinFET SRAMs when the ion track does not cross the
drain
(a)
(b)
Fig. 8
Examples for MCU bit maps in a memory array


















