
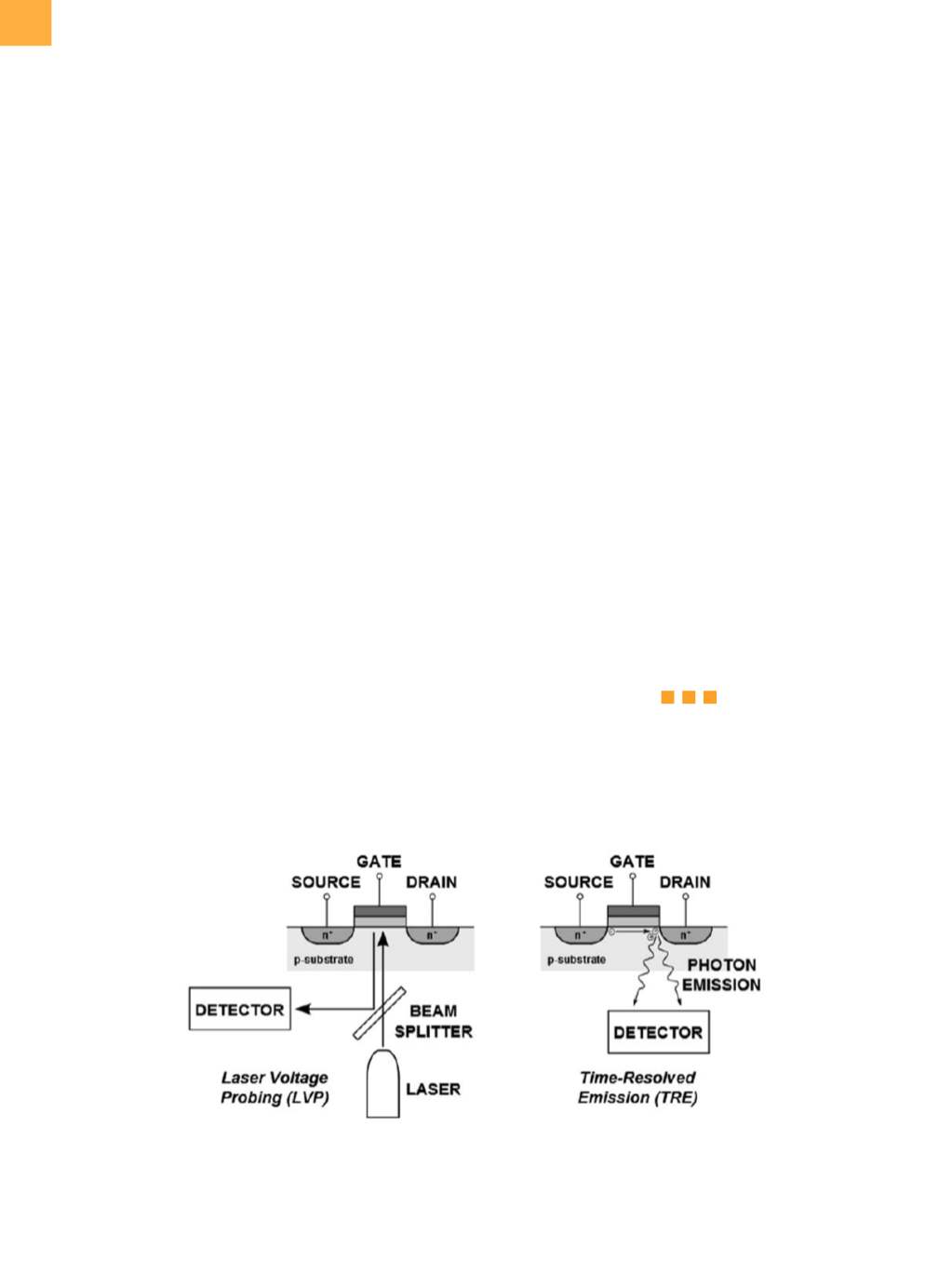
edfas.org
ELECTRONIC DEVICE FAILURE ANALYSIS | VOLUME 18 NO. 4
16
SUPERCONDUCTING SINGLE‑PHOTON DETECTOR
ENABLES TIME‑RESOLVED EMISSION TESTING OF
LOW‑VOLTAGE SCALED ICs
Andrea Bahgat Shehata, Franco Stellari, and Peilin Song
IBM T.J. Watson Research Center, Yorktown Heights, NY
andrea.bahgat@gmail.com stellari@us.ibm.com,
psong@us.ibm.comTIME-RESOLVED OPTICAL PROBING OF
SIGNALS ON SCALED ICs
Notwithstanding the continuous advances in design-
for-manufacturing and design-for-test features, the use
of noninvasive optical techniques for probing waveforms
from internal nodes of integrated circuits (ICs) remains
very important for the fast and accurate localization of
failures.
Currently, laser voltageprobing (LVP)
[1]
is themost com-
monly used time-resolved technique. A continuous-wave
laser beam is focused through a high-numerical-aperture
(NA) optical systemto a specific transistor. When a voltage
waveform is applied across the transistor under test,
there is a change in free-carrier density that alters the
local refractive index and the silicon absorbance, thus
giving rise to a modulation in the reflected laser light.
The small modulation in the light reflected from the
structure is detected by a fast photodiode (Fig. 1a). This
method is extremely sensitive and has only a modest
EDFAAO (2016) 4:16-22
1537-0755/$19.00 ©ASM International
®
“LUCKILY, NOVEL PHOTODETECTORS
SUCH AS THE SUPERCONDUCTING
SINGLE‑PHOTON DETECTOR (SSPD) THAT
HAVE BECOME AVAILABLE IN RECENT
YEARS HAVE HELPED RETURN THE LIGHT
TO THE TRE TECHNIQUE, DUE TO LOWER
NOISE (FEW DARK COUNTS PER SECOND)
AND BETTER JITTER .”
(a)
(b)
Fig. 1
Comparison of the two main optical techniques used to detect timing‑related faults within an IC. (a) In LVP, a laser is
shined toward the device, and the reflected light is modulated by the carriers and detected by a detector. (b) In TRE,
NIR photons are spontaneously emitted by the IC and collected by the detector.
















